
铭衍海(常州)微电子有限公司
 高级会员
高级会员 已认证
已认证

铭衍海(常州)微电子有限公司
 高级会员
高级会员 已认证
已认证

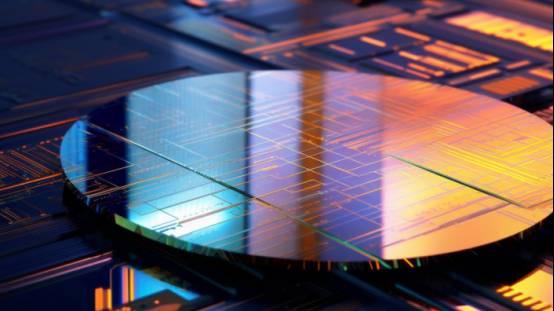
化学机械抛光(CMP)工艺
在半导体制造领域,晶圆量产良率与制程长期稳定性,是衡量产线核心竞争力的核心指标,更是决定芯片规模化量产、降本增效的关键命脉。近年来,随着国内 8/12 英寸硅基晶圆产线的持续扩产、碳化硅(SiC)等第三代半导体晶圆产线的规模化落地,成熟可控的全流程加工工艺,已成为推动晶圆量产良率稳步攀升、实现核心制程自主可控的核心抓手。
从碳化硅粉末到功率芯片的完整制备流程中,晶圆切磨抛环节,尤其是化学机械抛光(CMP)工艺,是决定晶圆全局平坦化、把控衬底加工质量、决定后续全流程制程良率的 “卡脖子” 核心工序。
01芯片制备核心基石:晶圆切磨抛的不可替代性
完整的碳化硅 / 硅基芯片制备流程,从碳化硅粉末原料出发,经单晶生长形成晶锭,再经切片、研磨、抛光形成超精密晶圆衬底,后续经外延生长、光刻、沉积、离子注入等数十道工序,最终形成可落地应用的功率芯片,全流程环环相扣,每一步都直接影响最终良率。

在这一全流程中,衬底的超精密加工,是整个芯片制造最为关键的一环—— 其加工质量不仅直接影响后续外延生长的晶体质量,更最终决定了器件的电学性能、长期可靠性与量产良率。
其中,碳化硅单晶的核心生长工艺,是衬底制备的源头,其结构如下图所示:
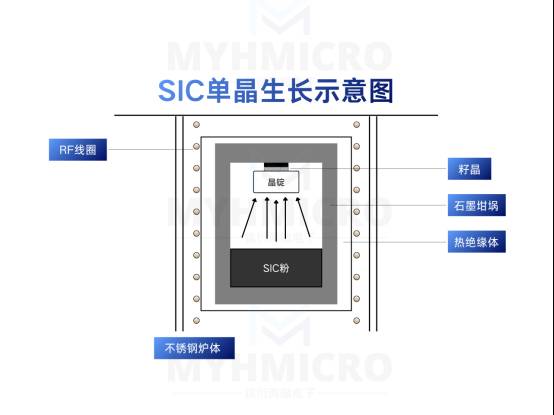
传统的基于沉积的局部平坦化技术,仅能实现宏观层面的 “亮面” 效果,无法解决晶圆表面的微观凹凸、划痕与亚表面损伤,更无法满足先进制程对全局平坦化的纳米级严苛要求。化学机械抛光(CMP)工艺,是目前行业内能实现晶圆表面全局均匀平坦化的核心技术,是晶圆切磨抛全流程中,决定衬底最终品质的 “最后一公里”。
02.CMP 化学机械抛光工艺:纳米级精密加工
CMP 工艺是化学腐蚀作用与机械研磨作用的完美协同,其核心原理与制程结构如下图所示:
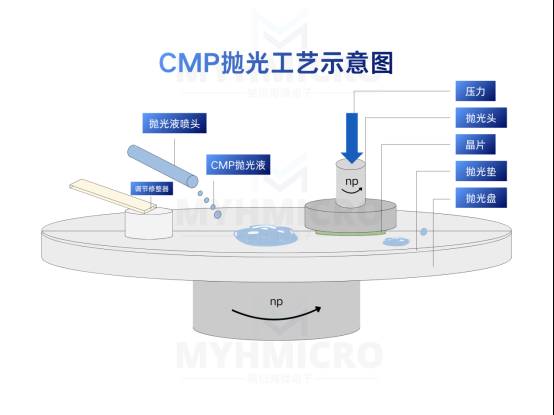
在抛光过程中,抛光头将待加工晶圆以恒定压力压在附着抛光垫的旋转抛光盘上,晶圆与抛光盘做同向旋转运动;同时,抛光液喷头将 CMP 抛光液持续、均匀地供给至抛光垫表面,通过抛光垫的微孔结构与纤维纹理,将抛光液均匀输送至晶圆抛光界面,通过两大核心作用实现纳米级材料去除:
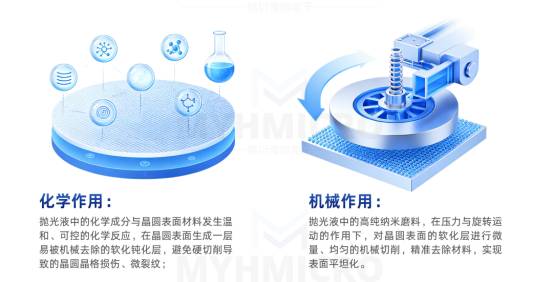
二者的精准协同,让 CMP 工艺既可以高效去除前道切片、研磨工序产生的加工余量与损伤层,又能实现原子级的表面精度控制,最终得到无划痕、无麻点、无亚表面损伤、全局超高平坦度的晶圆表面,为后续外延生长、光刻等核心工序筑牢基础。
03.CMP工艺:决定晶圆量产良率的核心命脉
对于规模化量产的晶圆产线而言,CMP 工艺的稳定性与加工质量,直接决定了整条产线的良率上限与量产稳定性,其核心影响体现在四大维度:


铭衍海(常州)微电子有限公司,深耕精密抛光耗材领域多年,聚焦半导体晶圆 CMP 制程核心需求,打造了从粗抛到终抛全粒径覆盖的氧化硅 CMP 抛光液产品矩阵,完美适配半导体衬底的全工序抛光需求,为国内晶圆产线提供成熟、稳定、高性价比的核心耗材解决方案,助力产线实现制程可控、良率稳步提升。
核心产品优势
MYHMICRO
1. 全粒径全流程覆盖,一站式适配晶圆切磨抛全工序
针对晶圆全流程需求,铭衍海打造了全粒径覆盖的产品矩阵,可一站式满足晶圆切磨抛全工序需求,无需多品牌耗材适配调试,大幅简化产线流程,提升制程稳定性。
2. 化学机械精准协同,兼顾效率与无损伤加工
产品采用高纯球形单分散纳米磨料,粒径分布极窄,无尖锐棱角、无团聚,配合定制化的化学配方体系,实现化学腐蚀与机械切削的精准平衡。既可以高效去除前道工序的加工余量与深层损伤层,又能避免产生新的划痕、亚表面晶格损伤。
3. 极致悬浮稳定性,保障量产批次一致性
采用特制分散配方体系,久置不分层、不沉淀、不团聚,在产线循环使用过程中性能长期稳定,彻底解决传统抛光液因沉降导致的抛光不均、良率波动问题,助力产线实现稳定规模化量产。
铭衍海系列产品相较传统抛光液的核心性能优势对比如下表所示:

在全球半导体产业竞争日趋激烈的当下,核心制程与核心耗材的自主可控,已成为国内半导体产业发展的核心命题。CMP 化学机械抛光工艺,作为晶圆制造全流程中的核心环节,其技术突破与产品成熟度,直接决定了国内半导体产业的制程上限与量产能力。
铭衍海微电子将持续深耕 CMP 抛光耗材领域,以技术创新为核心驱动力,不断打磨产品性能、完善产品矩阵,为国内晶圆制造企业提供成熟、稳定、高效的 CMP 抛光解决方案,以成熟制程筑牢芯片量产良率基石,助力国内半导体产业实现高质量发展与自主可控。

最新动态
更多





请拨打厂商400电话进行咨询
使用微信扫码拨号