中国粉体网讯 在当今数字化浪潮席卷全球的时代,电子设备的性能和集成度不断刷新着人们的认知。从每秒运算数亿次的超级计算机,到能揣在口袋里随时与世界互联的智能手机,其内部精密复杂的电气连接网络,如同人类的神经系统,是设备实现各项功能的核心命脉。而TGV(玻璃通孔)孔内电镀薄层技术,作为构建现代电子设备电气连接的关键密码,正悄然重塑着电子工业的发展格局。
TGV技术:电气连接的新基石
TGV技术,简单来说,就是在玻璃基板上制造微小的垂直通孔,并在这些通孔内电镀一层导电的金属薄层,从而实现不同层面之间的电气连接。玻璃基板凭借其低介电常数、良好的热稳定性和机械性能,成为了理想的电气连接载体。相较于传统的硅基板,玻璃基板不仅成本更低,而且在高频信号传输时损耗更小,能有效保障信号的完整性和传输速度。
制造TGV的第一步是在玻璃基板上加工出精确的通孔。这一过程如同在坚硬的岩石上开凿隧道,需要借助高精度的加工技术,如激光钻孔、湿法蚀刻或干法刻蚀等。其中,激光钻孔技术利用高能量的激光束瞬间熔化或气化玻璃材料,形成孔径小至几微米、深宽比可达10:1甚至更高的通孔。这些微小的通孔,是后续实现电气连接的基础通道,其尺寸精度和表面质量直接影响着最终的电气性能。
通孔加工完成后,便进入了电镀薄层的关键环节。电镀基于电化学原理,将玻璃基板浸入含有金属离子(如铜离子)的电解液中,并在基板和阳极之间施加电流。在电场的作用下,金属离子向基板表面迁移,并在通孔内壁上得到电子,逐渐沉积形成一层均匀致密的导电金属薄膜。这层看似薄薄的金属层,实则是电气连接的“生命线”,它为电子信号搭建起了畅通无阻的传输桥梁。
电镀薄层:电气连接的核心要素
TGV孔内电镀薄层的质量,直接决定了电气连接的可靠性和性能。均匀、致密的电镀层能够有效降低接触电阻,减少信号传输过程中的损耗和延迟,确保电子设备的高效运行。而若电镀层存在孔洞、裂纹或厚度不均等问题,不仅会增加电阻,还可能引发信号干扰、短路等故障,严重影响设备的稳定性和使用寿命。
为了获得高质量的电镀薄层,需要严格控制多个工艺参数。首先是电流密度,它直接影响着金属离子的沉积速率和分布。过高的电流密度可能导致孔口部分金属沉积过快,形成“尖端效应”,造成电镀层厚度不均;而过低的电流密度则会延长电镀时间,降低生产效率。其次是电解液的成分和浓度,合适的添加剂能够改善金属离子的扩散性能,抑制副反应的发生,从而提高电镀层的质量。此外,电镀温度、搅拌速度等因素也会对电镀效果产生影响,需要进行精确调控。
在实际生产中,TGV孔内电镀面临着诸多挑战。例如,对于高深宽比通孔来说,物理气相沉积的设备和工艺过于昂贵,因此,近年来研发人员开发了多种新的方案,美国安美特公司报道了金属氧化物黏附增强方法,通过把玻璃基板浸入化学药液,覆盖纳米厚度的金属氧化物助黏胶形成黏附层提高化镀铜层的黏附力,当黏附层的厚度增加至5-20nm时,铜与玻璃之间的剥离强度达到6N/cm以上。
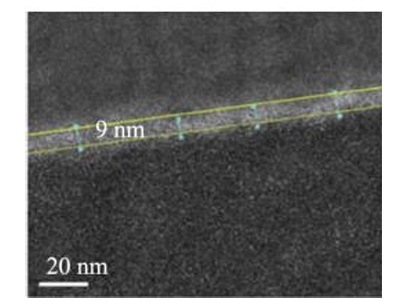
9nm厚的金属氧化物粘附层以提高铜黏附力 来源:安美特
乔治亚理工学院研发人员将环氧聚合物干膜贴在玻璃表面,提高化镀铜与玻璃之间的结合力,在薄玻璃衬底上层压介质层,在增强玻璃衬底机械强度的同时,可以作为表面重分布层(RDL)的黏附层,增强抗剥离强度。
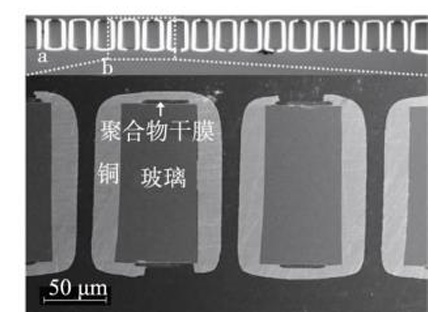
通过聚合物干膜方案来增强Cu的黏附力 来源:Viswanathan.High frequency electrical performance and thermo-mechanical reliability of fine-pitch, copper-metallized through package-vias (TPVs) in ultra-thin glass interposers
未来展望
随着物联网、人工智能、量子计算等新兴技术的快速发展,对电子设备的性能和集成度提出了更高的要求,TGV孔内电镀薄层技术也将迎来更大的发展机遇和挑战。
在技术创新方面,科研人员正致力于开发新型的玻璃材料和电镀工艺。例如,研究具有更低介电常数、更高热稳定性的玻璃材料,以进一步提升高频信号传输性能;探索新的电镀技术,实现更薄、更均匀的电镀层沉积,满足高密度电气连接的需求。
在应用拓展方面,TGV技术有望在更多领域发挥关键作用。在量子计算领域,TGV电气连接能够实现高速、低损耗连接,为量子计算机的性能提升提供支持;在生物医疗电子领域,TGV技术的微型化和高可靠性特点,可用于制造植入式医疗设备,实现更精准的信号采集和传输。
参考来源:
广发证券《半导体设备系列研究之玻璃基板从零到一,TGV为关键工艺》
陈力.玻璃通孔技术研究进展
Viswanathan.High frequency electrical performance and thermo-mechanical reliability of fine-pitch, copper-metallized through package-vias (TPVs) in ultra-thin glass interposers
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!


















