
中国粉体网讯 在现代电子技术的飞速发展中,电子设备正朝着小型化、高性能化的方向不断迈进。为了满足这一趋势,各种先进的技术应运而生,玻璃通孔(TGV)金属化技术便是其中之一。
TGV金属化是什么?
TGV金属化,简单来说,就是在玻璃基板上制作出微小的通孔,并在这些通孔内填充金属,从而实现电气连接和信号传输的技术。玻璃基板具有良好的电气绝缘性、热稳定性以及较低的介电常数等优点,非常适合应用于电子设备中。而通过在玻璃基板上实现通孔金属化,能够为芯片等电子元件提供高效的互连通道,极大地提升电子设备的性能。
TGV金属化的工艺步骤
玻璃基板选择与处理:首先要挑选合适的玻璃材料,像高品质硼硅玻璃或石英玻璃就常被选用,它们热膨胀系数低,介电性能高。选好后,需对玻璃基板进行仔细清洗和预处理,保证其表面干净、没有缺陷,为后续工艺打下良好基础。
通孔制作:这一步有多种微细加工技术可供选择,比如喷砂、超声波钻孔、湿法刻蚀、深反应离子刻蚀(DRIE)、光敏刻蚀、激光刻蚀等。其中,激光诱导深度刻蚀(LIDE)是较为先进的方法,它能精准控制孔径大小,高深宽比的通孔结构,同时还能让侧壁保持平滑,减少裂纹和粗糙度。
种子层沉积:在玻璃通孔内壁要沉积一层很薄的金属种子层,一般采用溅射工艺。这层种子层的作用是为后续电镀时铜或其他导电材料的附着提供基础,就如同在土地上播下种子,为后续生长做准备。在半导体制造中,种子层的均匀性和质量对最终的金属化效果至关重要。
填充导电材料:通过电镀工艺将铜等导电材料填入已做好的通孔内,形成垂直互连的导电路径。这个过程必须保证通孔被完全填充,不能有空洞,否则会影响电气性能。在大规模生产中,需要精确控制电镀的参数,如电流密度、电镀时间等,以确保每个通孔都能高质量地填充金属。
平坦化与去膜:完成电镀后,要对表面进行化学机械平坦化(CMP)处理,去除多余的金属,让基板表面平整。之后还要去除相关的保护膜等。平整的表面有利于后续的电路连接和封装等工艺,就像建造房屋时,需要先把地面平整好一样。
再布线与封装连接:在玻璃基板上建立重新分布层(RDL),进行电路布局和引脚设计,以便与其他芯片或外部封装元件连接。然后添加凸点(bump)或其他互连结构,如焊球,完成芯片间的电气和机械连接。这一步就像是搭建一个交通网络,将各个电子元件连接起来,实现它们之间的协同工作。
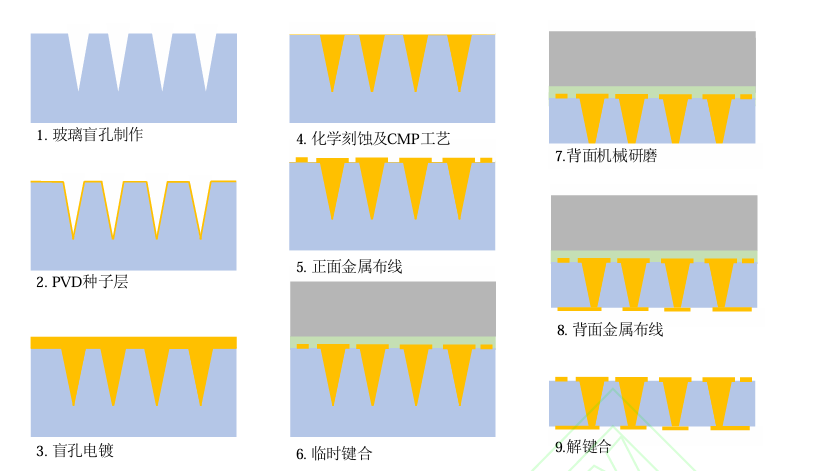
单面盲孔电镀TGV金属化工艺流程 来源:《玻璃通孔技术的射频集成应用研究进展》(喻甜等)
TGV金属化的优势
高频性能优异:玻璃材料的低介电损耗和高介电常数特性,使得玻璃通孔金属化技术在高频应用中表现出色,能实现高频信号的低损耗传输。在5G通信设备中,信号传输频率高,使用TGV金属化技术可以有效减少信号损耗,提升通信质量。
封装密度高:它能够实现多个芯片或电路元件的堆叠封装,显著提高了封装密度,让电子设备体积更小、重量更轻的同时,性能和可靠性还能得到提升。在智能手表等小型化电子设备中,就充分利用了这一优势,在有限的空间内集成更多功能。
成本效益较好:虽然前期投入可能较高,但从长远看,由于提高了封装密度和生产效率,降低了后续维护和更换成本,整体具有较高的成本效益。而且玻璃基板成本相对硅基板更低,进一步降低了成本。
TGV金属化的应用领域
半导体封装:通过玻璃基板上的微米级通孔实现多层芯片垂直互连,提升集成密度,助力半导体行业迈向3D集成与微型化。像英特尔等公司计划将TGV金属化技术应用于数据中心芯片,通过玻璃中介层实现高带宽内存(HBM)与中央处理器(CPU)的低延迟连接,大幅提升带宽。
5G通信:其低信号损耗特性满足5G毫米波通信对高频器件的要求,可有效提高射频模块的信号完整性。例如,厦门大学于大全团队利用该技术制备的毫米波封装天线,通过多层玻璃晶圆堆叠实现了低损耗信号传输。
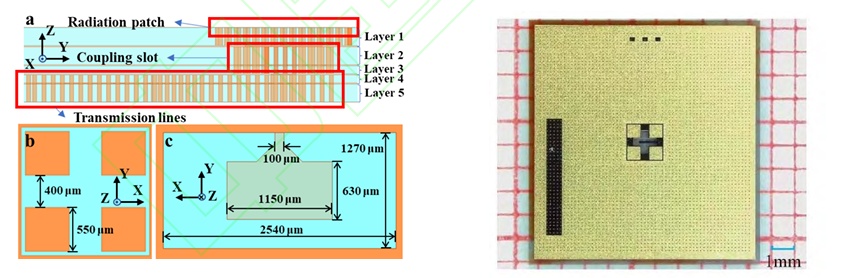
五层玻璃堆叠TGV封装天线 来源:Su.Development of compact millimeter-wave antenna by stacking of five glass wafers with through glass vias
医疗设备:在植入式医疗设备传感器封装、微创手术机器人等医疗领域,玻璃的高绝缘性、耐腐蚀性以及TGV金属化技术的精密性都具有独特优势。比如在心脏起搏器等植入式设备中,可靠的电气连接和良好的生物兼容性至关重要,TGV金属化技术就能发挥重要作用。
参考来源:
喻甜.玻璃通孔技术的射频集成应用研究进展
Yu.Development of embedded glass wafer fan-out package with 2D antenna arrays for 77 GHz millimeter-wave chip
Su.Development of compact millimeter-wave antenna by stacking of five glass wafers with through glass vias
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!